고성능·저전력 14나노 공정 적용...전력효율 20% 이상 개선
첨단 패키지 기술로 AP·D램·낸드플래시·PMIC 통합…초소형 구현
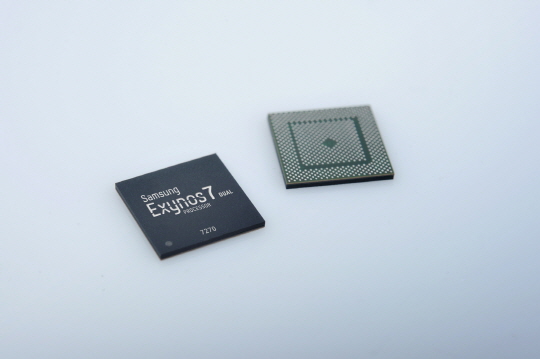 14나노 핀펫 공정을 적용한 웨어러블 전용 AP.ⓒ삼성전자
14나노 핀펫 공정을 적용한 웨어러블 전용 AP.ⓒ삼성전자
첨단 패키지 기술로 AP·D램·낸드플래시·PMIC 통합…초소형 구현
삼성전자가 14나노 핀펫(FinFET) 공정을 적용한 웨어러블 전용 애플리케이션프로세서(AP) '엑시노스 7270'를 양산한다고 11일 밝혔다.
그동안 프리미엄 모바일 AP에 적용되던 고성능·저전력 14나노 첨단 공정을 웨어러블 전용 AP에 적용한 것은 업계 최초다. 삼성전자는 그동안 14나노 공정을 모바일 분야에서 프리미엄 제품 위주로 적용해 왔으며 올해 초 활용범위를 보급형까지 확장했다.
듀얼코어를 사용한 '엑시노스 7270'은 14나노 공정 적용을 통해 기존 28나노 기반 제품 대비 동작 전력 효율을 20% 이상 향상시켜 웨어러블 기기 사용자들이 한 번 충전으로 장시간 사용할 수 있도록 했다.
또 Cat.4 롱텀에볼루션(LTE) 모뎀과 와이파이(Wi-Fi), 블루투스, FM라디오, 글로벌 위성항법장치(GNSS) 등 다양한 통신 기능까지 하나의 칩에 통합, 단독으로도 통신망을 이용한 편의기능을 사용할 수 있도록 했다.
이와 함께 최첨단 패키지 기술을 통해 시스템 면적을 최소화함으로써 웨어러블 기기에 최적화된 저전력 초소형 제품을 제공할 수 있도록 했다.
AP·D램·낸드플래시에 더해 PMIC(Power Management IC)까지 하나의 패키지에 담는 첨단 패키지 기술(SiP-ePoP)을 적용해 전 세대 제품과 동일 면적인 100mm2에 더 많은 기능을 구현했을 뿐 아니라 패키지 높이를 약 30% 줄였다.
PMIC는 AP의 필요 전압을 효율적으로 공급 및 관리하는 반도체를 일컫으며 SiP-ePoP는 시스템인 패키지(System-in-Package)와 임베디드 패키지 온 패키지(embedded Package-on-Package)의 약자로 첨단 패키지 기술의 한 형태다.
또 웨어러블 기기 제조사들에게 AP·디스플레이, 근거리무선통신(NFC) 및 각종 센서 등으로 구성된 레퍼런스 개발 플랫폼을 제공해 고객들이 보다 빠르고 편리하게 제품을 개발할 수 있도록 했다.
허국 삼성전자 시스템LSI사업부 전략마케팅팀 상무는 "이번 제품은 저전력 공정과 모뎀·커넥티비티 통합, 혁신적인 패키지 기술을 바탕으로 웨어러블 전용 시스템온칩(SoC)의 패러다임을 제시하는 제품”이라며 "기기의 사용시간을 크게 늘리고 슬림한 디자인을 구현할 수 있게 해 웨어러블 대중화에 큰 기여를 하게 될 것”이라고 밝혔다.
©(주) 데일리안 무단전재 및 재배포 금지
0
0
기사 공유

이홍석 기자 (redstone@dailian.co.kr)
기사 모아 보기 >
관련기사
댓글
0
/ 150
-
최신순
-
찬성순
-
반대순
0 개의 댓글 전체보기
 실시간 랭킹뉴스
실시간 랭킹뉴스
댓글 쓰기